4月27日,全球先进陶瓷领导者Kyocera集团宣布,随着AI数据中心不断向大型化发展的xPU、交换ASIC等尖端半导体封装升级,公司开发了一种独有的多层陶瓷基板,可实现高密度布线,还能降低封装时的翘曲度,产品计划在5月美国举行的半导体封装国际会议上正式展出。
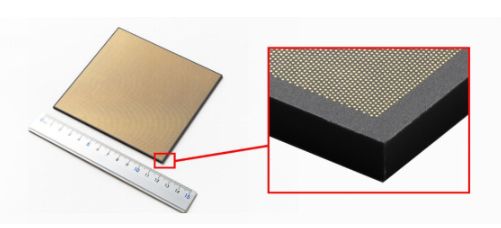
Kyocera开发的新型陶瓷基板焊盘(Pad)直径:75µm、间距:200µm
Kyocera表示,随着生成AI和大规模语言模型(LLM)的普及,全球范围内数据中心的建设与扩展正在加速,基于2.5D封装的封装基板大型化和高密度布线正在加速,有机基板已无法满足上述趋势要求。而Kyocera研发的陶瓷基板可减少翘曲和利于减薄,并且在垂直连通的通孔加工是生坯加工工艺,因此加工精度更高。同时,Kyocera公司表示,产品可以根据客户的设备规格和实施条件,进行热应力、电仿真以及考虑部件安装过程的电路板翘曲仿真等应对措施,并且基于这些测试结果给出层压陶瓷核心板的定制设计建议。